服务热线
18574304394
2026-03-28 13:51:00
由深圳瑞沃微半导体科技有限公司发布 | 2026-03-28 深圳
所谓芯片尺寸封装即CSP(Chip Size Package或Chip Scale Package)。根据JEDEC(美国电子器件工程联合委员会)JSTK-012标准规定,凡LSI芯片封装面积小于或等于芯片面积120%的产品,均可称为CSP。CSP技术的出现,使VLSI在高性能、高可靠性的前提下实现了接近裸芯片尺寸的最小封装形式,同时相对成本更低,因而高度契合电子产品小型化的发展趋势,成为极具市场竞争力的高密度封装形式。本文将从CSP的特点、类别、制作工艺以及生产研发等方面详细论述这一先进封装技术,并对我国CSP技术研发提出几点建议。
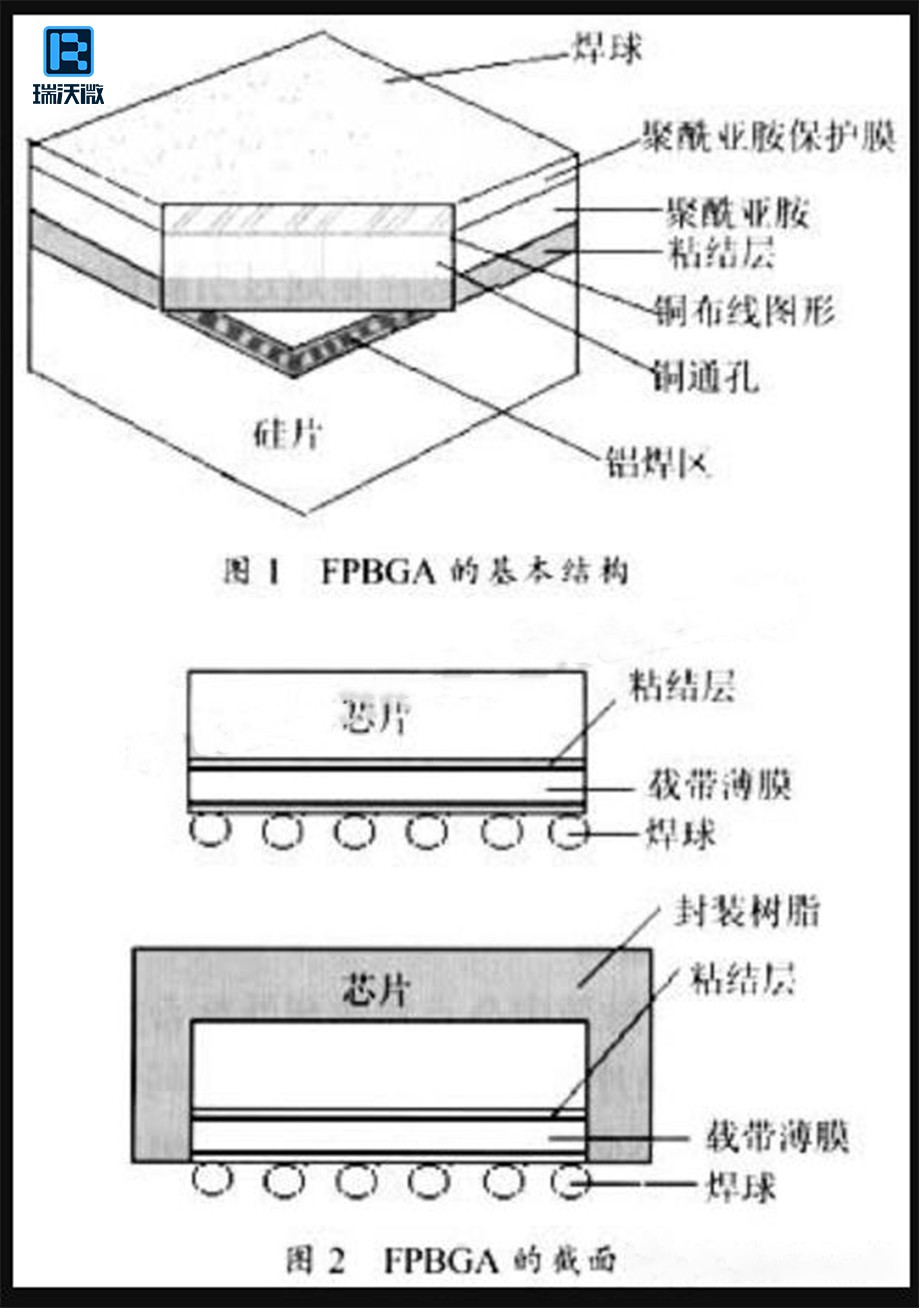
CSP本质上是在BGA封装小型化过程中衍生而来的,因此也有人将其称为μBGA(微型球栅阵列),如今μBGA仅被视为CSP的一种形式。正因如此,CSP自然继承了BGA封装技术的诸多优点。CSP是目前体积最小的VLSI封装之一,其封装面积通常不足0.5毫米,间距仅为QFP的十分之一,BGA的三分之一至十分之一,充分体现了其在微型化方面的显著优势。CSP不仅显著提升了封装密度,还有效缩短了信号传输路径,改善了电气性能,同时具备优良的散热能力和可靠性,广泛适用于移动终端、存储器件、微处理器等对尺寸和性能要求苛刻的领域。根据结构形式的不同,CSP可分为柔性基板型、刚性基板型、引线框架型及晶圆级封装等多种类型,各类别在工艺复杂度、成本控制和适用范围上各有侧重。
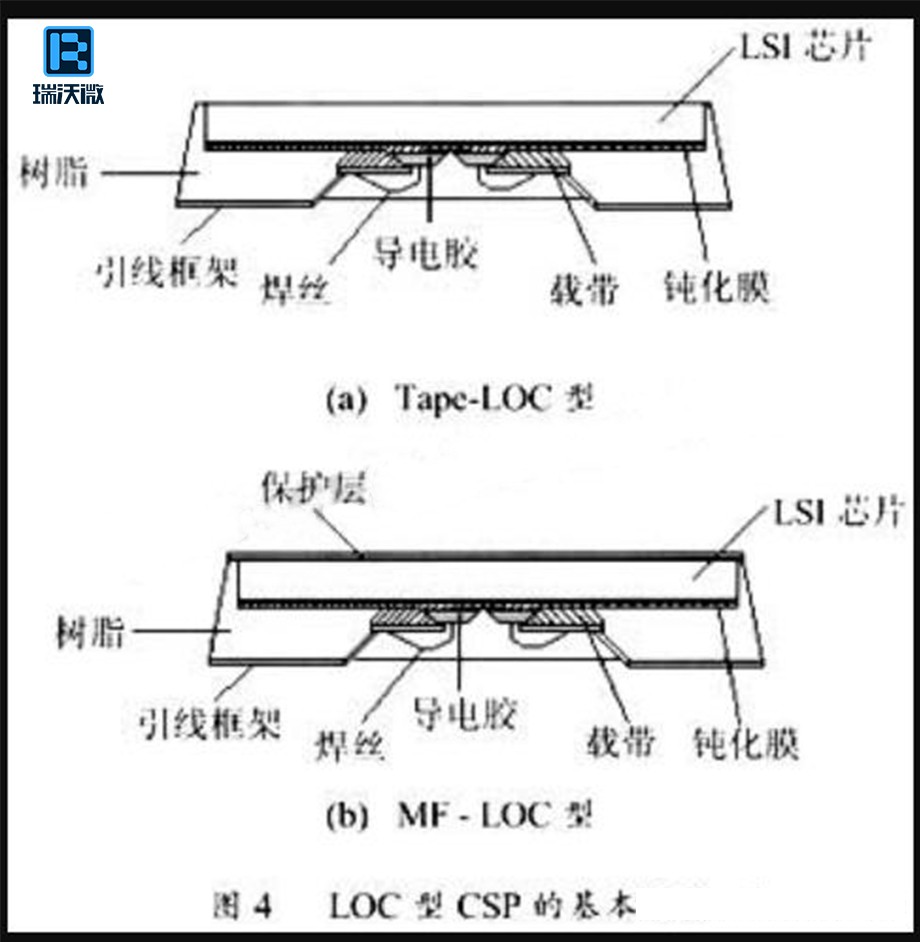
其中,晶圆级CSP因在晶圆状态下完成封装再切割,实现了真正意义上的芯片级尺寸封装,成为当前发展最为迅速的技术方向。在制作工艺方面,CSP涉及凸点制作、基板互连、塑封成型等关键环节,对设备精度和工艺控制能力要求极高。当前,全球CSP技术已趋于成熟,产业化规模持续扩大,而我国在相关领域的研发虽已起步,但仍存在产业链协同不足、高端工艺自主化程度偏低等问题。为此,应加强基础研究与工艺平台建设,推动产学研深度融合,集中突破关键材料与核心装备瓶颈,同时加快制定统一的技术标准与测试规范,以提升我国在CSP领域的自主创新能力与市场竞争力。
该文章部分内容或图片来源自互联网,如有侵权请联系删除。