服务热线
18574304394
2026-01-23 08:00:00
由深圳瑞沃微半导体科技有限公司发布 | 2026-01-22 深圳
CSP(Chip Scale Package)封装,意为芯片级封装,是一种自身体积与芯片自身大小相比,不超过20%的先进封装技术。作为最新一代的内存芯片封装技术,瑞沃微CSP不仅在技术性能上实现了新的突破,更在尺寸上达到了惊人的小巧程度。其芯片面积与封装面积之比可超过1:1.14,接近理想的1:1比例,且绝对尺寸仅为32平方毫米,约为普通BGA封装的1/3,甚至不及TSOP内存芯片面积的1/6。得益于CSP封装,同等空间下的存储容量可提高三倍。
目前,业界正朝着更先进的衬底级别封装技术迈进,其封装尺寸与芯片完全相同。为了实现这一目标,LED制造商在不断精简结构,例如采用标准高功率LED、去除陶瓷散热基板和连接线、金属化P和N极,以及在LED上方直接覆盖荧光层等创新设计。据Yole Développement统计,预计到2020年,CSP封装将占据高功率LED市场的34%,成为驱动芯片效能提升的重要力量。
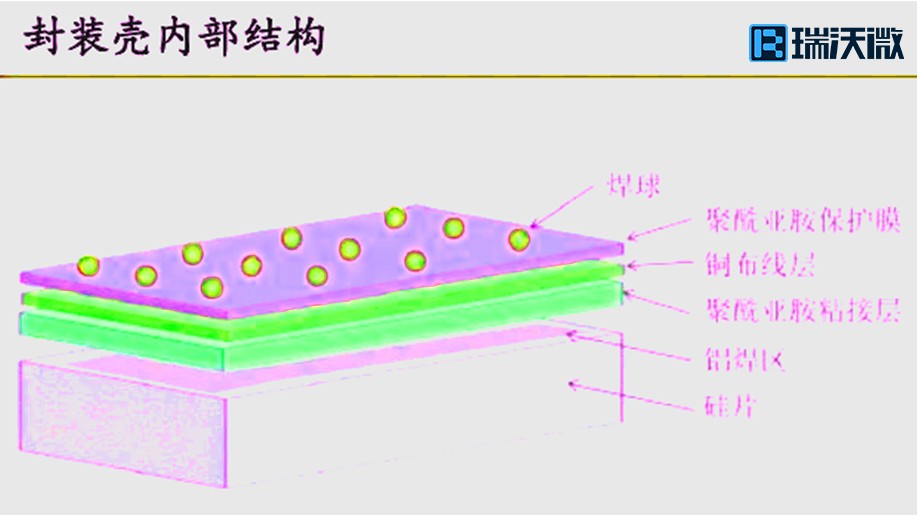
CSP封装内存芯片的独特设计,如中心引脚形式,有效缩短了信号传导距离,减少了信号衰减,并显著提升了芯片的抗干扰和抗噪性能。这使得CSP的存取时间相比BGA技术改善了15%-20%。在封装工艺上,瑞沃微CSP封装采用锡球焊接将内存颗粒与PCB板相连,由于焊点与PCB板的接触面积广泛,使得芯片运行中产生的热量能迅速传导并散发。其背面散热设计不仅热效率优异,更使得CSP的热阻降低至35℃/W,优于TSOP的40℃/W。
CSP技术的诞生正是为了应对电子产品更新换代的需求。当大芯片(功能更全、性能更优、复杂性更高)逐渐替代小芯片时,CSP技术能确保封装体占用印刷板的面积保持不变或甚至减小。这一技术特性使得CSP在手持式移动电子设备中得到了广泛应用。自1996年8月日本Sharp公司开始批量生产CSP封装以来,该技术便迅速在全球范围内得到推广应用。如今,已有数十家世界知名公司能够提供上百种CSP封装,充分满足了市场的多样化需求。
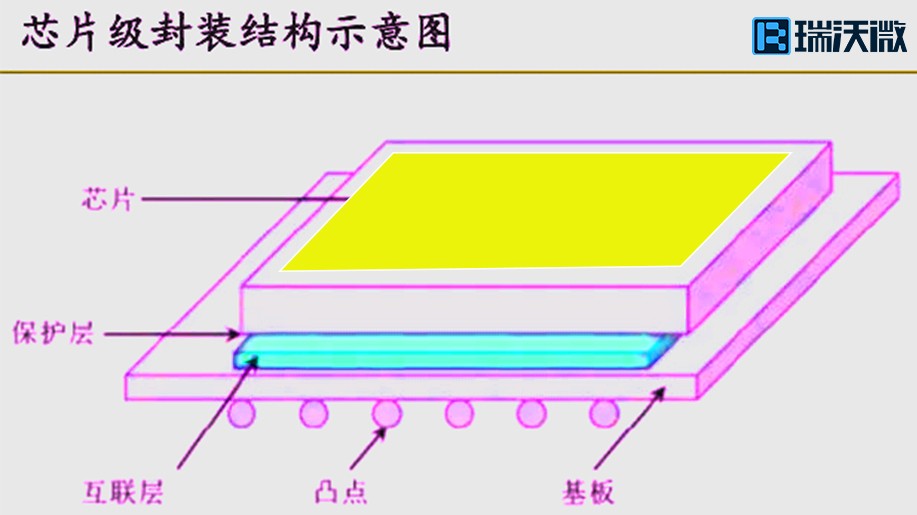
CSP以其独特的特点在电子行业中脱颖而出。首先,其封装尺寸小巧,不仅节省了空间,还便于集成更多的电子元件。此外,CSP的散热性能优异,金属基板到散热体的最短路径仅0.2毫米,确保了内存芯片的长时间运行可靠性。同时,其中心引脚设计有效缩短了信号传导距离,减少了信号衰减,并提升了抗干扰和抗噪性能。这些特点使得CSP封装在存取时间上相比BGA技术有了显著的提升,达到了15%-20%的改善。此外,锡球焊接工艺使得芯片运行中产生的热量能迅速传导并散发,背面散热设计更进一步优化了热效率。总的来说,CSP以其高效、可靠的特性在电子产品中占据了不可或缺的地位。
在众多封装方式中,CSP以其紧凑的尺寸和轻盈的重量脱颖而出。其面积和厚度均处于行业领先地位,使得在相同输入/输出端数的情况下,CSP的面积仅为0.5mm间距QFP的十分之一左右,甚至是BGA(或PGA)的三分之一到十分之一。因此,在组装过程中,CSP能显著减少对印制板面积的占用,提升整体组装密度。其薄型设计更适用于薄形电子产品的组装需求。此外,CSP的重量也大幅减轻,相较于相同引线数的QFP,其重量可减轻至五分之一以下,相较于BGA更是减轻更多。这样的优势对于航空、航天等对重量有着严格要求的领域而言,无疑是极为有利的。
在限定尺寸内,CSP能够提供更多的输入/输出端数。举例来说,对于尺寸为40mm×40mm的封装,QFP的最多端子数为304个,而BGA能达到600-700个,但CSP却能轻松达到1000个以上。尽管目前CSP主要应用于输入/输出端数较少的电路封装,但其潜力已显而易见。
由于CSP内部芯片与封装外壳布线间的互连线长度显著短于QFP或BGA,这使得其寄生参数大大减小,进而信号传输延迟时间也相应缩短。这一优势对于改善电路的高频性能具有重要意义。CSP技术以其轻薄的特点,使得芯片产生的热量能够通过短通道迅速传导至外界。借助空气对流或安装散热器的手段,可以实现对芯片的高效散热。
深耕细作,十年磨一剑。瑞沃微专注于CSP技术的研发与应用,力求在芯片散热领域达到专业水准。
该文章部分内容或图片来源自互联网,如有侵权请联系删除。